
近日,日本Patentix公司宣布在新型半導體材料——金紅石型二氧化鍺(rutile-type GeO2,簡稱r-GeO2)薄膜上,通過離子注入方式成功引入施主雜質(zhì)銻(Sb),首次實現(xiàn)了其n型導電性。這一突破為下一代高耐壓、高效率功率半導體器件的設(shè)計與制造提供了全新材料選項。
作為一種具備4.68 eV超寬禁帶的氧化物半導體,r-GeO2在理論上優(yōu)于SiC和GaN,具備更高的擊穿電壓與熱穩(wěn)定性。然而,長期以來該材料在電子摻雜方面面臨挑戰(zhàn),限制了其實際應(yīng)用進展。
Patentix此前已基于自研PhantomSVD薄膜沉積技術(shù),在成膜過程中引入銻元素,實現(xiàn)了r-GeO2的n型導電調(diào)控,并成功驗證其在肖特基勢壘二極管(SBD)中的應(yīng)用可行性。
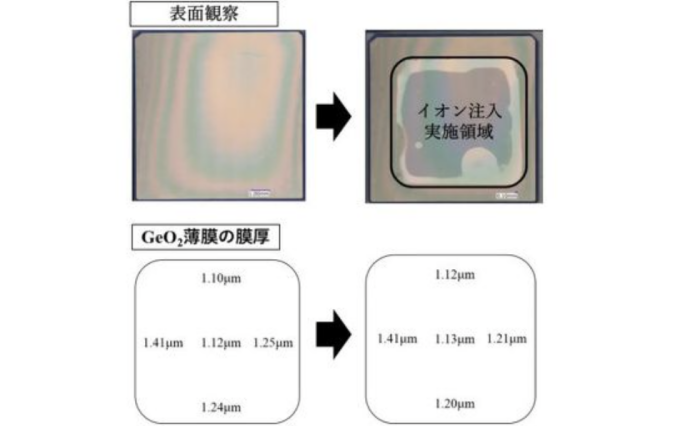
r-GeO2薄膜在離子注入前(左)和后(右)的表面和厚度
此次進一步采用離子注入法,將銻摻雜精準地引入至已沉積好的r-GeO2薄膜中,具備更高的摻雜空間分辨率和濃度控制能力。實驗結(jié)果顯示,注入?yún)^(qū)域保持晶體結(jié)構(gòu)穩(wěn)定,且片電阻明顯下降,說明施主雜質(zhì)已被激活,有效提升了導電性能。
后續(xù)通過C-V(電容-電壓)特性分析確認了n型導電行為,并揭示摻雜雜質(zhì)主要分布在薄膜表面附近。未來,Patentix將進一步評估銻的具體注入濃度及活化效率,持續(xù)推動r-GeO2材料體系在高性能功率器件中的工程化應(yīng)用。
粉體圈Coco編譯

作者:粉體圈
總閱讀量:280供應(yīng)信息
采購需求
