
最近,Materials Today Physics(今日材料物理學(xué))期刊在線定稿發(fā)表了來自中南大學(xué)的最新研究成果,科研團(tuán)隊(duì)通過多級界面層設(shè)計(jì)開發(fā)了導(dǎo)熱能力、熱膨脹匹配和熱穩(wěn)定性全面提升的金剛石/Cu復(fù)合材料。
論文地址:https://doi.org/10.1016/j.mtphys.2025.101818

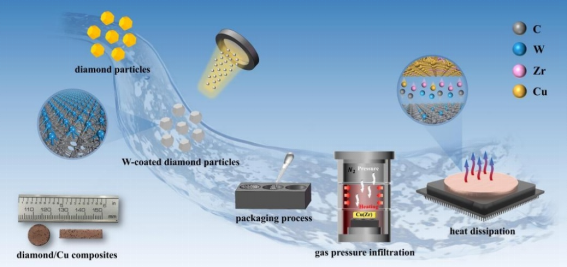
金剛石/Cu復(fù)合材料制備渲染示意圖
高性能計(jì)算芯片的多功能集成和微型化的發(fā)展加劇了封裝材料的熱管理挑戰(zhàn)。銅(Cu)作為一種低廉且高可加工性的金屬,是導(dǎo)電和導(dǎo)熱應(yīng)用的主力材料。近年來,隨著合成金剛石技術(shù)高速發(fā)展使其成本下降,高達(dá)2200W?m熱導(dǎo)率卓越特性的金剛石導(dǎo)熱應(yīng)用自然進(jìn)入業(yè)內(nèi)視野。金剛石/Cu復(fù)合材料也備受關(guān)注。在之前一些相關(guān)研究中,通過引入界面過渡層可以耦合厚度控制來獲得優(yōu)異的熱性能,但金剛石/Cu復(fù)合材料的熱膨脹系數(shù)(CTE)仍然遠(yuǎn)未達(dá)到先進(jìn)的電子封裝標(biāo)準(zhǔn),并且在實(shí)際應(yīng)用中導(dǎo)熱能力的衰減仍然是限制其工程應(yīng)用的主要障礙。
科研團(tuán)隊(duì)在本次研究中,通過磁控濺射和氣體壓力輔助浸滲(GPI)技術(shù),成功地在金剛石/Cu復(fù)合材料中引入了由WC層和W-ZrC固溶體(WC-(Zr,W)C)組成的連續(xù)多層界面層。最終獲得高性能復(fù)合材料,熱導(dǎo)率743W/m·K,323K(約50℃)下熱膨脹系數(shù)4.5×10?6K?1,大氣環(huán)境循環(huán)百次后熱擴(kuò)散系數(shù)僅下降20.7%。這項(xiàng)工作不僅解決了金剛石/Cu復(fù)合材料的工程應(yīng)用挑戰(zhàn),深入理解了增強(qiáng)機(jī)制,還為熱管理復(fù)合材料中的界面層設(shè)計(jì)提供了新的視角。
編譯 YUXI

作者:粉體圈
總閱讀量:641供應(yīng)信息
采購需求
